Ионный источник КауфманаРефераты >> Технология >> Ионный источник Кауфмана
ИОС должна юстироваться оптически для обеспечения соосности отверстий;
должно быть оптимизировано отношение потенциала плазмы и потенциалу ускоряющей сетки.
В технологических МИИ возникает необходимость нейтрализации пространственного заряда ионного потока, обусловленная, во-первых, низкой скоростью распыления диэлектрических мишеней вследствие накопления на них поверхности положительного заряда и, во-вторых, расфокусировкой ионного потока.
Нейтрализация осуществляется двумя способами:
I. На пути ионного потока размещается вольфрамовая или танталовая нить, является термоионным эмиттером. Недостатки этого метода - малый ресурс внешнего термоионного эмиттера, распыление материала нити и загрязнение обрабатываемой поверхности. Применение метода ограничено ионными пучками малого диаметра.
2. Метод "плазменного моста", состоящий в формировании вспомогательного плазменного потока, замыкающегося на ионный пучок и обеспечивающего нейтрализацию.
Многоаппертурные источники ионов серийно выпускаются в США фирмами Veeco, Commonwelth Seintific, Ion Tech, CSC и другими в виде универсальных автономных установок и в составе технологических систем.
3. Модификации источника Кауфмана и тенденции его развития
Для повышения однородности потока используются мультипольные системы на постоянных магнитах, в зоне полюсных наконечников которых размещаются аноды, и мультикатодные системы /4/.
Ионный источник с мультикатодной системой разработанный фирмой CSC представлен на рис.17.
Ионный источник с мультикатодной системой
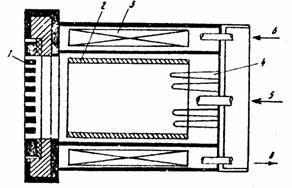
I - экстрактор, 2 - анод, 3 - электромагнит, 4 - система катодов (мультикатоды), 5 - напуск рабочего газа, 6 - водяное охлаждение.
Рис.17
Можно выделить следующие тенденции развития технологических многолучевых источников:
увеличение диаметра ионного потока;
использование нескольких термокатодов с целью повышенения равномерности пространственного распределения плазмы в объеме разрядной камеры;
увеличение ресурса термокатодов;
применение мультипольных магнитных систем и многоанодных систем для повышения однородности плазмы в разрядной камере;
нейтрализации объемного заряда ионного потока.
4. Применение ионных источников в технологии
В технологических процессах создания сверхбольших и сверхскоростных ИС (СБИС и ССИС) широко используются ионные, ионно-плазменные и плазмохимические процессы взаимодействия ионных потоков и низкотемпературной плазмы с поверхность твердого тела. В универсальных технологических системах, оборудованных ионными источниками можно проводить многие операции очистки, ионно-пучкового травления и распыления. В полупроводниковой микроэлектронике широко применяются технологии ионной имплантации и реактивного ионно-лучевого травления (РИЛТ) /1/.
Применение совокупности электронно-ионных процессов, получивших общее название «элионная технология», позволяет повысить точность изготовления микроструктур, создать высокопроизводительное автоматизированное промышленное оборудование.
Ионно-лучевая обработка материалов характеризуется следующими особенностями:
· большая энергия активирующего воздействия пучков на материал, подвергаемый обработке;
· возможность управления пучками с малой инерционностью посредством электромагнитных полей;
· селективность активирующего воздействия;
· возможность управления технологическим процессом с помощью ЭВМ;
· ионные процессы протекают в вакууме или плазме, что гарантирует сохранение чистоты обрабатываемого материала.
В полупроводниковой ыикроэлектронине широко применяется технология ионной имплантации. Ионная имплантация - эффективный метод технологической обработки, основанный на взаимодействии управляемых потоков ионов с поверхностью твердого тела с целью изменения его свойств, связанных с атомной структурой. Установка ионной имплантации представляет собой электрофизический комплекс, генерирующий пучок с заданными свойствами, создающий возможность взаимодействия пучка с мишенью и обеспечивающий контроль и управление характеристиками пучка и объектам имплантации /5/.
Ионный источник является одним из важнейших узлов установки ионной имплантации. От конструкции источника зависит надежность и основные рабочие характеристики всей установки в целом.
Установки имплантации для производства СБИС и ССИС характеризуются широким диапазоном параметров:
масса легирующих примесей 1 - 250 а.е.м.
ток ионного пучка 10-9-5*10-2 А
энергия ионов 5-3[103 кэB
доза имплантации 109 -1017 см2
производительность до 4 м2 кремния /г
Выделяют три основных группы промышленных установок ионной имплантации: высокоэнергетические, малых и средних доз, больших доз с интенсивными ионными пучками.
Основными легирующими примесями в технологическом процессе имплантации являются такие элементы, как бор, фосфор, мышьяк, сурьма, цинк, алюминий, селен, галий. Для радиального воздействия используется водород, аргон, азот, гелий.
Рабочее вещество может подаваться в разрядную камеру источника в виде элементарного газа или газоразрядных соединений твердых веществ . Для ионизации твердых веществ используется их испарение в тигле, нагреваемом до высоких температур, и последующая подача паров рабочего вещества в разрядную камеру источника. Используется также эффект катодного распыления тугоплавкого материала и его ионизация в плазме вспомогательного инертного газа.
Промышленное применение разнообразных методов ионно-лучевой обработки материалов повышает требования к ионным источникам. Главным образом это касается увеличения интенсивности ионных потоков, повышения ресурса, возможности использования различных рабочих веществ и разных сортов ионов, высокой стабильности рабочих параметров, снижения энергоемкости и металлоемкости установки.
заключение
Существует большое разнообразие ионных источников, применение которых в технологии микроэлектроники открывает широкие перспективы.
Ионный источник Кауфмана по сравнению с другими имеет ряд существенных преимуществ: низкое напряжение разряда (~20 В), благодаря чему ионный пучок содержит небольшое количество примесей (10-6%) и имеет малый энергетический разброс; механизм поддержания стационарного разряда позволяет применять многолучевое извлечение ионного пучка и работать с однородными потоками большого диаметра; осцилляция электронов позволяет использовать низкое давление в разрядной камере, что снижает потери пучка и уменьшает загрязнение мишени; источник имеет высокий газовый к.п.д. (80 %) и высокий энергетический к.п.д.
Однако этот источник имеет ряд недостатков конструкции: использование термокатода ограничивает срок службы источника и не позволяет работать с химически активными рабочими веществами, кроме того, плазма в магнитном поле подвержена неустойчивостям, ухудшающим стабильность параметров ионного пучка и его оптические свойства.
