Печатные платыРефераты >> Технология >> Печатные платы
б) Изготовление биполярных ИМС методом коллекторной изолирующей диффузии (КИД) – изолированные карманы и одновременно коллекторные n+n++-области формируются в процессе диффузии донорной примеси сквозь тонкий (1 ¸ 2 мкм) эпитаксиальный p-слой (рис 17). Для изолирующей диффузии необходимы окна в SiO2-маске (на рисунке не указаны), перекрывающие скрытые n+-области. После диффузии получаются изолированные n+p-карманы. Базовая p+-диффузия проводится без SiO2-маски, что исключает фотолитографию и упрощает технологический процесс.
В КИД-технологии число фотолитографий уменьшается по сравнению с предыдущим процессом. Область коллектора сильно легирована, поэтому нет необходимости для повышения быстродействия ИМС проводить дополнительную диффузию золота или другой понижающей время жизни неосновных носителей тока примеси. Однако в эпитаксиальной базе дрейф носителей от эмиттера к коллектору уменьшен, что понижает быстродействие ИМС. Кроме этого тонкий эпитаксиальный слой ограничивает пробивное напряжение коллектор-база из-за распространения объемного заряда в базовую область.
 |
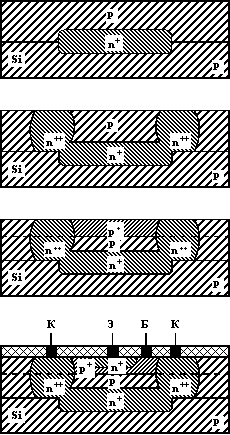
6.3 Изготовление биполярных ИМС с диэлектрической изоляцией
Диэлектрическая изоляция обеспечивает лучшие параметры ИМС.
![]() а) Изоляция пленкой диэлектрика с использованием поликристаллического кремния реализуется в эпик-процессе. Исходной заготовкой является однослойная nn+-структура (рис 18). После локального травления на глубину около 15 мкм и удаления SiO2-маски термически выращивают или осаждают из паро-газовой фазы пленку диоксида кремния толщиной 1 ¸ 2 мкм. Поверх нее осаждают слой высокоомного поликремния толщиной 175 ¸ 200 мкм. Для получения изолированных n+n-карманов лишнюю часть кремния сошлифовывают. Полученная при этом подложка структуры ИМС, как и при изоляции p-n-переходом, проводящая, хотя и имеет более высокое удельное сопротивление. Для улучшения изоляции слой SiO2 иногда заменяют слоем Si3N4, двойными слоями SiO2–Si3N4 или SiO2–SiC.
а) Изоляция пленкой диэлектрика с использованием поликристаллического кремния реализуется в эпик-процессе. Исходной заготовкой является однослойная nn+-структура (рис 18). После локального травления на глубину около 15 мкм и удаления SiO2-маски термически выращивают или осаждают из паро-газовой фазы пленку диоксида кремния толщиной 1 ¸ 2 мкм. Поверх нее осаждают слой высокоомного поликремния толщиной 175 ¸ 200 мкм. Для получения изолированных n+n-карманов лишнюю часть кремния сошлифовывают. Полученная при этом подложка структуры ИМС, как и при изоляции p-n-переходом, проводящая, хотя и имеет более высокое удельное сопротивление. Для улучшения изоляции слой SiO2 иногда заменяют слоем Si3N4, двойными слоями SiO2–Si3N4 или SiO2–SiC.
Таким образом, получение кремниевых карманов в поликристаллическом кремнии выполняется по меза-эпитаксиальной технологии. Элементы ИМС в этих карманах далее формируются по планарной технологии. В целом процесс можно охарактеризовать как меза-эпитаксиально-планарный. Наряду с приведенным маршрутом имеются его модификации. Например получение комплементарных биполярных ИМС, в составе которых имеются p-n-p и n-p-n транзисторы (рис 19).
Эпик-процессы относительно сложны и трудоемки. Основная сложность заключается в необходимости прецизионной механической обработки. К недостатку метода также относится относительно небольшая степень интеграции. ИМС.
Эпик-процессы относительно сложны и трудоемки. Основная сложность заключается в необходимости прецизионной механической обработки. К недостатку метода также относится относительно небольшая степень интеграции. ИМС.
б) Необходимо отметить, что эпик-технология требует прецезионной механической обработки, которая затруднена из-за наличия прогиба подложки в результате различия коэффициентов температурного линейного расширения монокристаллического и поликристаллического кремния и оксида кремния. Различие микротвердости этих материалов приводит к наличию ступенек на поверхности, что затрудняет получение качественной металлизации. С целью устранения отмеченных недостатков разработаны технологические процессы, в которых вместо поликристаллического кремния для изолирующих областей и основания кристаллов используют стекло, ситалл или керамику, т.е. проводят изоляцию диэлектрическим материалом. Такие процессы имеют общее название «кремний в диэлектрике» (КВД). У них много общего с обычным эпик процессом. Отличие состоит в том, что сначала фор мируют элементы ИМС (рис 20,а), а затем пластину с элементами со стороны выводов подвергают локальному травлению – создают мезаобласти (рис 20,б). После этого пластину со стороны мезаобластей прикрепляют к вспомогательной пластине (рис 20,в), а ее обратную сторону подвергают шлифованию (рис 20,г) с последующим нанесением изолирующего диэлектрика (рис 20,д). Завершают процесс удалением вспомогательной пластины (рис 20,е) и металлизацией.
мируют элементы ИМС (рис 20,а), а затем пластину с элементами со стороны выводов подвергают локальному травлению – создают мезаобласти (рис 20,б). После этого пластину со стороны мезаобластей прикрепляют к вспомогательной пластине (рис 20,в), а ее обратную сторону подвергают шлифованию (рис 20,г) с последующим нанесением изолирующего диэлектрика (рис 20,д). Завершают процесс удалением вспомогательной пластины (рис 20,е) и металлизацией.
Диэлектрическая изоляция по сравнению с p-n изоляцией технологически сложнее; площадь, занимаемая элементами, больше. Но, благодаря лучшим электрическим свойствам, она постоянно совершенствуется и широко применяется в производстве биполярных ИМС.

6.4 Изготовление биполярных ИМС с комбинированной изоляцией
В основу изготовления полупроводниковых биполярных ИМС с комбинированной изоляцией положены процессы, обеспечивающие формирование элементов с изоляцией p-n переходами их горизонтальных участков и диэлектриком – вертикальных боковых областей.
 |
