Вторично-ионная масса спектрометрия
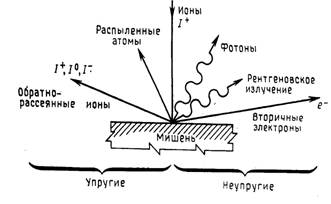
Фиг.3. Схематическое представление взаимодействия ионов с мишенью [2].
Неупругие взаимодействия с электронами мишени вызывают вторичную электронную эмиссию, характеристическое рентгеновское излучение и испускание световых квантов. Упругие взаимодействия приводят к смещению атомов кристаллической решетки, появлению дефектов и поверхностному распылению. Эти процессы схематически проиллюстрированы на фиг. 3.
Энергетический спектр рассеянных твердотельной мишенью ионов с начальной энергией Е0 схематически представлен на фиг.4. Здесь видны широкий низкоэнергетический (10 - 30 эВ) горб, соответствующий испусканию нейтральных атомов (распыленные атомы), и высокоэнергетический горб, расположенный вблизи энергии первичного иона Е0 (упругорассеянные ионы).
Вторично-ионная эмиссия
Основные физические и приборные параметры, характеризующие метод ВИМС, охватываются формулами (1) - (3). Коэффициент вторичной ионной эмиссии SА±, т. е. число (положительных или отрицательных) ионов на один падающий ион, для элемента А в матрице образца дается выражением
SА±=gА±САS, (1)
где gА± - отношение числа вторичных ионов (положительных или отрицательных) элемента А к полному числу нейтральных и заряженных распыленных частиц данного элемента, а СА -атомная концентрация данного элемента в образце. Множитель S - полный коэффициент распыления материала (число атомов на один первичный ион). В него входят все частицы, покидающие поверхность, как нейтральные, так и ионы. Величины gА± и S сильно зависят от состава матрицы образца, поскольку отношение gА± связано с электронными свойствами поверхности, а S в большой степени определяется элементарными энергиями связи или теплотой атомизации твердого тела. Любой теоретический способ пересчета измеренного выхода вторичных ионов в атомные концентрации должен, давать абсолютное значение отношения gА± или набор его приведенных значений для любой матрицы.
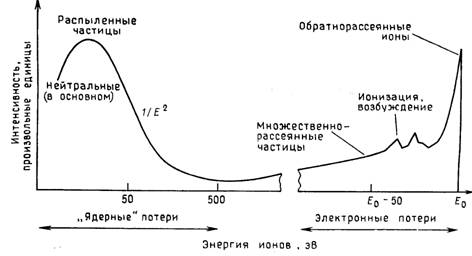
Фиг.4. Энергетический спектр электронов, рассеянных при соударении с твердотельной мишенью [2].
Вторичный ионный ток iА± (число ионов в секунду), измеряемый в приборе ВИМС, дается выражением
iА± =hASA±IP, (2)
где iА± - ионный ток для моноизотопного элемента (для данного компонента многоизотопного элемента ионный ток равен faiА±, где fa,- содержание изотопа а в элементе А). Величина hA -эффективность регистрации ионов данного изотопа в используемом приборе ВИМС. Она равна произведению эффективности переноса ионов через масс-анализатор на чувствительность ионного детектора. Множитель hA обычно можно рассматривать как константу, не зависящую от вида элемента или массы изотопа, если энергетические распределения вторичных ионов примерно одинаковы и имеют максимум при нескольких электрон-вольтах, так что зависящее от массы изменение чувствительности детектора частиц мало. Наконец, IP полный ток первичных ионов (число ионов в секунду), падающих на образец.
Конечно, величина IP связана с плотностью тока первичных ионов DP (число ионов за секунду на 1 см2) и диаметром пучка d (см). Если для простоты принять, что сечение пучка круглое, а плотность DP тока постоянна в пределах сечения, то
IP=(0,25p)DPd2. (3)
При существующих источниках первичных ионов, используемых в приборах ВИМС, плотность тока на образец, как правило, не превышает 100 мА/см2 (в случае однозарядных ионов ток 1 mА соответствует потоку 6.2 1015 ион/с). В табл. 1 приводятся типичные значения параметров, входящих в формулы (1) - (3).
Таблица 1.
Типичные значения параметров
в формулах (1)- (3) [1].
| gА± | 10-5¸10-1 |
| S | 1¸10 |
| hA | 10-5¸10-2 |
| DP | 10-6¸10-2 mA/cm2 |
| d | 10-4¸10-1 cm |
Самое важное значение в вопросе о возможностях ВИМС как метода анализа поверхностей имеет взаимосвязь между параметрами пучка первичных ионов, скоростью распыления поверхности и порогом чувствительности для элементов. Из-за отсутствия информации о такой взаимосвязи часто возникают неправильные представления о возможностях метода. Соотношения между током первичных ионов, диаметром и плотностью пучка, скоростью распыления
поверхности и порогом чувствительности при типичных условиях иллюстрируются графиком, представленным на фиг.5. Скорость удаления (число монослоев в секунду) атомов мишени при заданной энергии ионов пропорциональна плотности их тока DP, а порог чувствительности при регистрации методом ВИМС (минимальное количество элемента, которое можно обнаружить в отсутствие перекрывания пиков масс-спектра) обратно пропорционален полному току ионов IP. Коэффициент пропорциональности между порогом чувствительности ВИМС и IP определяется исходя из результатов измерений для ряда элементов в различных матрицах путем приближенной оценки, основанной на экспериментальных значениях для типичных пар элемент - матрица. При построении графика на фиг.5 предполагалось, что площадь захвата анализатора, из которой вторичные ионы отбираются в анализатор, не меньше сечения пучка первичных ионов. Данное условие обычно выполняется в масс-спектрометрии, если диаметр области, из которой поступают ионы, не превышает 1 мм.
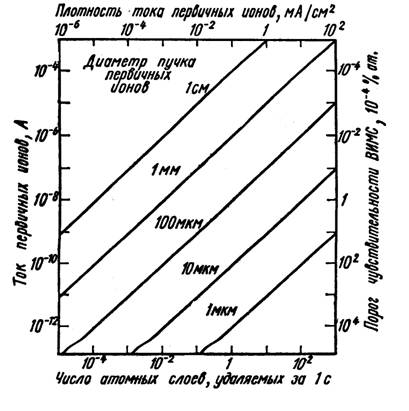
Фиг. Зависимость между током первичных ионов, диаметром и плотностью первичного
пучка, скоростью удаления атомных слоев и порогом чувствительности ВИМС[1].
Распыление ионным пучком - разрушающий процесс. Но если требуется, чтобы поверхность оставалась практически без изменения, то анализ методом ВИМС можно проводить при очень малых скоростях распыления образца (менее 10-4 монослоя в секунду) . Чтобы при этом обеспечить достаточную чувствительность метода ( »10-4 монослоя), как видно из фиг.5, необходим первичный ионный пучок с током 10-10 А диаметром 1 мм. При столь низкой плотности тока первичных ионов ( 10-5 мА/см2) скорость поступления на поверхность образца атомов или молекул остаточных газов может превысить скорость их распыления первичным пучком. Поэтому измерения методом ВИМС в таких условиях следует проводить в сверхвысоком или чистом (криогенном) вакууме.
Указанные приборные условия приемлемы не во всех случаях анализа. Например, определение профиля концентрации примесей, присутствующих в малых количествах в поверхностной пленке толщиной свыше 5ОО А, удобно проводить при диаметре пучка, равном 100 мкм, и при скорости распыления, превышающей 10-1 атомных слоев в секунду. Еще более высокие плотности ионного тока требуются, чтобы обеспечить статистически значимые количества вторичных ионов с единицы площади поверхности, необходимые при исследовании распределения по поверхности следов элементов при помощи ионного микрозонда или масс-спектрального микроскопа. На основании сказанного и данных фиг.5 мы заключаем, что невозможно обеспечить поверхностное разрешение в несколько микрометров для примеси, содержание которой равно »10-4%, при скорости распыления менее 10-3 атомных слоев в секунду. Это взаимно исключающие условия.
