Эпитаксиальный рост Ge на поверхности Si(100)
Данная система подготовки поверхности производится один раз.
Перед каждым новым осаждением германия пластина отжигалась при температуре 1100°C в течении двадцати минут. Для уменьшения влияния "истории" образца, из-за частичного растворения германия в подложке при отжиге, поверхность заращивалась слоем кремния ~200-300Å. Затем для выглаживания поверхности образец снова отжигался в течении 10 минут, после чего охлаждался естественной теплоотдачей (без принудительного охлаждения) до температуры последующего роста.
Проводя однообразно прогрев, охлаждение и заращивание кремнием перед каждым экспериментом, мы ожидаем минимального изменения исходной поверхности от эксперимента к эксперименту. О чем свидетельствует характерная дифракционная картина (2x1) для Si(100) реконструированной поверхности, наблюдаемая после всех предэпитаксиальных подготовок.
Результаты эксперимента
Исследован методом ДБЭ рост слоев германия на кремнии в диапазоне температур от 250 до 700ОС. На рис.7 представлена характерная дифракционная картина поверхности Si(100), при дифракции быстрых электронов на отражение под малым углом падения.

Рисунок 7. Дифракционная картина чистой поверхности Si(100).
Центральное пятно – рефлекс зеркально отраженного пучка электронов. Три темные полосы, крайние боковые и центральная – тяжи, полученные пересечением обратной двумерной решетки со сферой Эвальда. Между ними находятся сверхструктурные тяжи, возникающие из-за присутствия на поверхности дополнительной периодичности (2x1).
На рис.8 показана характерная дифракционная картина от поверхности псевдоморфной пленки Ge на Si(100). Толщина слоя Ge равна 2 монослоя.

Рисунок 8. Дифракционная картина поверхности Si(100) с пленкой Ge 2 монослоя. Стрелками показаны тяжи от реконструкции (8x2).
При толщине пленки около 1 монослоя (МС) на дифракционной картине формируется сверхструктура (2xN) где N=8-12. Эта структурная перестройка заключается в удалении рядов димеров с поверхности плёнки, что приводит к частичной упругой релаксации напряженного гладкого германиевого слоя, в результате на дифракционной картине появляются дополнительные сверхструктурные тяжи.
При дальнейшем увеличение толщины Ge, из-за роста с толщиной энергии напряжений, с некоторой толщины, пленке становится выгоднее частично снять напряжения за счет увеличения площади поверхности. В результате на поверхности подстилающего слоя начинают образовываться островки("hut" кластеры), когерентно сопряженные в основании с подложкой и имеющие форму четырехгранных пирамид с ориентацией граней типа {105}. В результате, на дифракционной картине тяжи от дифракции на поверхности заменяются на рефлексы от объемной дифракции (на просвет) от островков. Из-за четкой огранки островков, возле объемных рефлексов, появляются линии обусловленные рассеянием на гранях островков (см. рис.8).
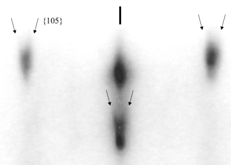
Рисунок 9.Дифракционная картина поверхности Si(100) с Ge "hut" кластерами (толщина пленки - 6 монослев). Стрелками показаны линии от рассеяния на гранях островков.
Увеличение толщины пленки Ge приводит к постепенному увеличению размеров "hut" островков, и при некоторой толщине трансформации "hut" островков в "dome". Характерная дифракционная картина от поверхности с "dome" островками показана на рис.9.

Рисунок 10. Дифракционная картина поверхности Si(100) с Ge "dome" островками (толщина пленки - 15 монослев). Стрелками показаны линии от рассеяния на гранях островков.
Расстояние на дифракционной картине между тяжами, в случае дифракции от поверхности или рефлексами, в случае дифракции от объема напрямую отражает значение параметра решетки (~1/a). Следя за изменением расстояния сначала между тяжами, а затем между положением объемных рефлексов можно контролировать "параметр решетки" растущей пленки в плоскости роста. На рис.10 представлено характерное поведение положения тяжей, в точках последующего появления объемных рефлексов.
Стрелками на рисунке показаны места на дифракционной картине вдоль которых снимался профиль интенсивности в процессе роста. Как видно из рисунка, в процессе роста расстояние между тяжами меняется. В начальный момент, когда дифракционная картина образована рассеянием на чистой поверхности кремния, можно считать, что расстояние между тяжами (l0) в этом случае соответствует параметру решетки объемного кремния. Тогда, изменение эффективной постоянной решетки в процессе роста можно вычислить по формуле:
da/a=1-l/l0
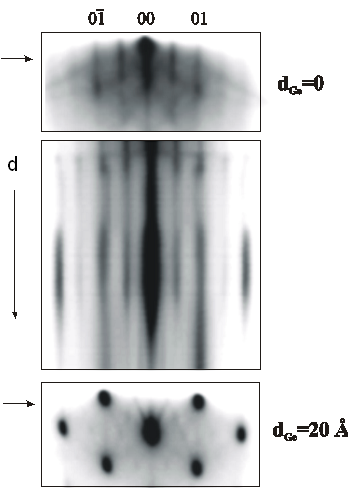
Рисунок 11. Изменение профиля интенсивности дифракционной картины вдоль горизонтального направления в процессе осаждения Ge на Si(100). Вверху и внизу показаны начальное и конечное изображение дифракционной картины.
Электронный луч, падающий под малым углом на поверхность (~0.50), проникает в поверхность неглубоко ~1-3 монослоя (для данной энергии электронов – 20кВ), поэтому параметр решетки рассчитанный из дифракционной картины соответствует параметру решетки самых верхних слоев поверхности.
На рис.12 показано характерное изменение эффективного параметра решетки в плоскости роста.
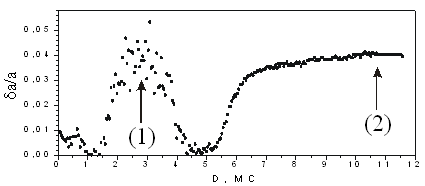
Рисунок 12. Изменение "параметра решетки" в процессе осаждения. (1) – Переход 2D-3D. (2) – Полная релаксация "dome" островков.
На зависимости параметра решетки от толщины можно выделить несколько характерных моментов изменения поведения:
Начиная с толщины пленки около одного монослоя и до трех монослоев, наблюдается рост параметра решетки.
В этой области напряженной пленке германия становится выгоднее иметь на поверхности большое количество двумерных островков, т.к. они частично снижают напряжения за счет релаксации. При этом, оказываясь сжатыми в основании, на верхней, свободной границе островки могу быть наоборот растянуты. С увеличением толщины пленки, увеличивается энергия упругих напряжений в пленке, и для ее снижения поверхности выгоднее иметь все большее и больше количество двумерных островков.
2. С трех до пяти монослоев происходит падение параметра решетки до значения почти соответствующему значению параметра решетки кремния.
При толщине пленки около 3 монослоя на месте двумерных островков начинают образовываться трехмерные островки, когерентно сопряженные в основании с подложкой. Дифракционная картина в данной ситуации представляет собой сумму от дифракции на поверхности смачивающего слоя и только зародившихся трехмерных островков. Профиль интенсивности снимается в точке появления объемных рефлексов, интенсивность которых на данной стадии еще мала, поэтому основной вклад в интенсивность в выбранной на картине точке будет давать псевдоморфный смачивающий слой германия, который имеет в плоскости роста параметр решетки как у кремния. Поэтому переход 2D - 3D к временному падению эффективного параметра решетки растущей пленки.
