Эпитаксиальный рост Ge на поверхности Si(100)
3. С толщины пленки порядка пяти монослоев идет постепенное увеличение параметра, до тех пор, пока не достигнет значения параметра решетки объемного германия.
По мере падачи материала на поверхность, трехмерные островки увеличиваются в размерах. "Hut" островки, будучи когерентно сопряжены в своем основании с подстилающим слоем, имеющим в плоскости роста параметр решетки кремния, к своей вершине постепенно релаксируют. И чем больше размер островка, тем большие толщины подвержены релаксации. "Dome" островки срелаксированны еще больше. При некоторой толщине пленки введенные в "dome" островки дислокации несоответсвия уже настолько снимают напряжения в островках, что электронный луч прошедший через островок "чувствует" в нем параметр решетки объемного германия.
Были так же измерены изменения вертикального профиля интенсивности вдоль нулевого тяжа от времени роста пленок (рис.13а). Рисунок представляет из себя последовательность профилей интенсивности вдоль нулевого тяжа в зависимости от толщины пленки германия. Угол отложен в соответствии с дифракционными картинами, приведенными на рис.7-10 (т.е. дифракционный угол увеличивается вниз). На протяжении роста первых 2-3 МС на профилях присутствует один максимум, который соответствует зеркальному рефлексу. Эта область соответствует двумерно-слоевому росту пленки. Затем интенсивность зеркального рефлекса уменьшается, а рядом разгорается объемный рефлекс. По мере роста пленки, интенсивность объемного рефлекса увеличивается, и при некотором значении толщины пленки происходит сдвиг объемного рефлекса в сторону больших углов.
Таким образом можно выделить три характерных области по толщине пленки, которые хорошо согласуются с изменениями дифракционных картин:
1. До начала перехода к трехмерному росту (<3MC) профиль представляет из себя в основном узкий и интенсивный пик, зеркального рефлекса.
В этой области происходит сверхструктурный переход 2х1 в 2хN, который явно не проявляется на профилях интенсивности, но сопровождается существенным снижением интенсивности зеркального рефлекса при толщине пленки около 1МС.
2. После перехода к трехмерному росту (>5-10MC и >3-4MC) профиль также представлят из себя более узкий и интенсивный пик, теперь являющийся объемным рефлексом. По мере роста пленки происходит изменение в интенсивности и сильное смещение объемного рефлекса.
Как уже указывалось выше, в этой области толщин наблюдаются дифракционные картины, свидетельствующие об образовании псевдомофных "hut" кластеров с ориентацией граней типа {105}.
3. При больших толщинах (>5-10MC), как уже указывалось выше, рефлекс постепенно смещается в сторону больших углов.
В этой области толщин наблюдаются дифракционные картины, свидетельствующие об образовании трехмерных островков с дислокациями несоответствия и огранкой типа {113}.
На рис.13 цифрами указаны моменты смены характерных областей на профиле.
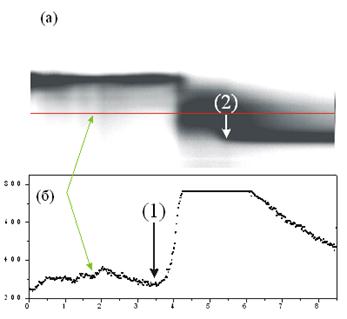
Рисунок 13. (а) – Изменение профиля интенсивности дифракционной картины вдоль вертикального направления в процессе осаждения Ge на Si(100). (б) – Изменение интенсивности вдоль выделенное линии на (а). (1) – Переход 2D – 3D рост (начало образования "hut" островков). (2) – Переход "hut" – "dome".
Таким образом из анализа изменения горизонтального и вертикального профиля интенсивности дифракционной картины можно выделить три характерные толщины растущей пленки: (1) – переход от двумерного роста к трехмерному и начало образования на поверхности "hut" островков, (2) – переход "hut"островков в "dome" и (3) – полная релаксация "dome" островков. На рис.14 представлена кинетическая диаграмма морфологии поверхности пленки Ge на Si(100) в процессе роста, в зависимости от эффективной толщины осажденного германия и температуры роста.
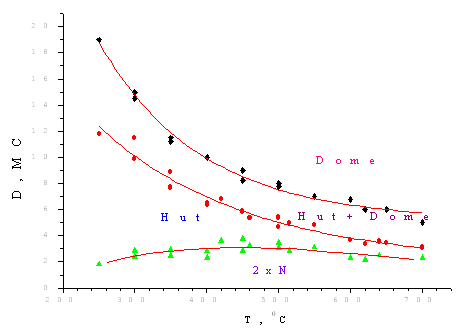
Рисунок 14. Кинетическая диаграмма морфологии поверхности пленки Ge на Si(100). Скорость осаждения Ge – 0.05МС/сек.
Точность положения точек по относительной температуре в пределах 1-2%, по абсолютной температуре (сдвиг по температуре всей диаграмм) около 200. Точность по определению характерных толщин, составляет около 10% и определяется в основном неточностью определения скорости потока германия на поверхность и стабильностью работы источника.
Обсуждение результатов
Сравнение диаграммы с данными имеющимися в литературе
Несмотря на большое количество работ, публикуемых в журналах по теме роста Ge на поверхности Si(100), данных которые можно было бы напрямую соотнести с результатами данной работы не много. Связано это с рядом обстоятельств. Во первых, почти половина работ по данной тематике посвящена исследованию роста твердого раствора GexSi1-x на Si(100). Эффективная постоянная решетки твердого раствора отличается от объемной решетки кремния уже не на 4%, как для случая эпитаксии чистого германия, а меньше, в зависимости от x. В результате, такие параметры растущей пленки, как критическая толщина перехода 2D - 3D, характерные размеры "hut" и "dome" островков могут значительно увеличиться. Получать изображение поверхности пленок с большими островками гораздо легче, и это можно делать "на воздухе" в атомарно-силовом микроскопе. Для получения изображений маленьких островков, обычно применяют сканирующую электронную микроскопию, без контакта образца с воздухом, либо просвечивающую электронную микроскопию уже захороненных островков.
Во вторых, много работ посвящено поиску оптимальных условий параметров роста, таких как, начальная структура поверхности, скорость и температура осаждения, временные задержки в процессе роста, использование сурфактантов и углеродных добавок и др.
На рис.15 представлено расположение экспериментальных точек, взятых из печатных источников [2,20,26,35,39,, ,,,,], по отношению к зависимостям, полученным в данной работе.
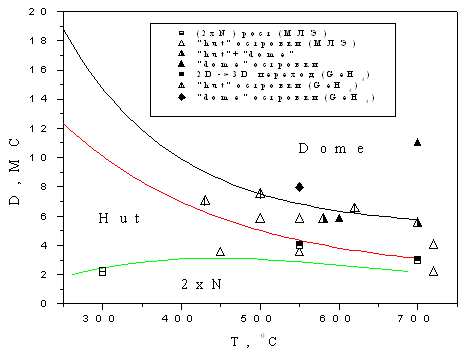
Рисунок 15. Сравнение литературных данных (тщчки)с результатами эксперимента в данной работе(сплошные линии).
Экспериментальные точки, с использованием метода газофазной эпитаксии лежат на несколько монослоев выше, чем для молекулярно-лучевой эпитаксии. Связано это с тем, что при осаждении из газовой фазы на поверхности растущей пленки присутствует водород, который уменьшает поверхностную диффузию адатомов и меняет энергию границы раздела кристалл-вакуум, т.е. действует аналогично сурфактанту. В остальном наблюдается удовлетворительное соответсвие экспериментальных наблюдений.
Температурное поведение характерных тощин
1). Температурное поведение 2D-3D перехода.
Поведение границы послойного и трехмерного роста при изменении температуры роста определяется характерной длинной миграции адатомов по поверхности.
