К155ие9Рефераты >> Радиоэлектроника >> К155ие9
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|

ФР — фоторезист
Рисунок 3 - Структура биполярного транзистора на различных этапах изолланарлого процесса
По завершении процесса фотолитографии фоторезист не удаляется и проводится ионное внедрение бора для создания р+-областей, при этом маской при локальном внедрении выступают двухслойная пленка SiO2+Si3N4 и фоторезист. Толщина р+-слоя выбирается таким образом, чтобы часть этого слоя после термического окисления сохранилась под слоем SiO2. Наличие сильнолегированной р+-области под изолирующим слоем SiO2 препятствует образованию под ним поверхностного инверсионного канала.
После удаления фоторезиста проводится локальное термическое окисление для получения изолирующих областей SiO2, перекрывающих по толщине весь эпитаксиальный слой. Пленка Si3N4 удаляется химическим травлением в горячей ортофосфорной кислоте.
По завершении операций по созданию изоляции формируется транзисторная структура. Вновь проводится термическое окисление и второй фотолитографией в слое фоторезиста создается рисунок базовых областей. При использовании фоторезиста в качестве маски проводится локальное ионное внедрение бора через пленку Si02. Внедрение примеси через пленку SiO2 ослабляет ка-налированный пучок ионов и снижает концентрацию радиационных дефектов. Третьей фотолитографией создается рисунок контактных окон. Размер области SiO2, разделяющей в топологическом плане области базы и эмиттера, выбирается соответствующим минимальному зазору, который может быть получен между металлическими контактами. Четвертая фотолитография формирует рисунок n+-областей эмиттера и коллектора. После плазмохимиче-ского травления SiO2 не снятый фоторезист является маской при локальном внедрении мышьяка. После удаления фоторезиста проводится отжиг при Т = 900°С, активирующий мышьяк и устраняющий радиационные дефекты.
Для получения омических контактов и электрической разводки между элементами на поверхность подложки наносится пленка алюминия и вжигается в водороде при Т = 500°С. Пятой литографией формируется рисунок электрической разводки. Поверхность готовой микросхемы защищается пленкой SiN, получаемой в процессе плазмохимического осаждения при температуре 400 °С.
3 Технология ТТЛ
На рисунке 4 показана схема самого распространенного логического элемента-основы серии К 155 и ее зарубежного аналога-серии 74.

в-МТТЛ; б—СТТЛ; а-МмТТЛ
Рисунок 4 - Принципиальные схемы первичных логических элементов ТТЛ
Эти серии принято называть стандартными (СТТЛ). Логический элемент серии К155 имеет среднее быстродействие 1ад,р,ср = 13 нс и среднее значение тока потребления З мА. Таким образом, энергия, затрачиваемая этим элементом на перенос одного бита информации, примерно 100 пДж.
Для обеспечения выходного напряжения высокого уровня Цвых > >2.5 В (как и в схеме на рис. 1.6, а) в схему на рис. 1.6,б потребовавлось добавить диод сдвига уровня VD4, падение напряжения на котором равно 0.7 В. Таким способом была реализована совместимость различных серий ТТЛ по логическим уровням. Микросхемы на основе инвертора, показанного на рис. 1.6,б (серия К155), имеют очень большую номенклатуру, широко выпускаются, а серия продолжает развиваться.
На рис. 1.6, а показан третий вариант ТТЛ первоначальной разработки—маломощный логический элемент (МмТТЛ). Он лежит в основе отечественной серии К134 и зарубежной с названием 74L (здесь L —low — означает малое быстродействие и одновременно малое потребление тока питания). Этот элемент потребляет мощность питания примерно 1 мВт при среднем времени задержки распространения 1зд,р,ср==33 нс, что соответствует энергии, потребляемой на перенос единицы информации Эпот = 33 пДж. Номиналы резисторов в этом логическом элементе относительно велики. Сейчас эти серии не развиваются. В конце 70-х годов микросхемы ТТЛ первоначальной разработки стали активно заменяться на микросхемы ТТЛШ, имеющие во внутренней структуре р-п переходы с барьером Шотки. Напомним, что эффект Шотки снижает пороговое напряжение открывания кремниевого диода от обычных 0.7 В до 0.2 .0.3 В и значительно уменьшает время жизни неосновных носителей в. полупроводнике. Эффект основан на том, что в р-n переходе или рядом с ним присутствует очень тонкий слой металла, богатый электронами — свободными носителям.
Сложности практического освоения технологических процессов изготовления полупроводниковых структур с эффектом Шотки, однако, были очень велики.
В основе транзистора с переходом Шотки (транзистора Шотки, ТШ) находится известная схема ненасыщаемого РТЛ-ключа (рисунок 5, а).
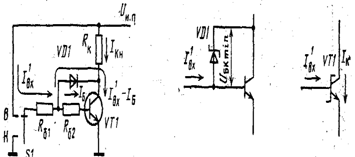
Рисунок 5 - Ненасыщаемый элемент РТЛ (а), транзистор с диодом Шотки (б) , символ транзистора Шотки (в)
Здесь транзистор удерживается от перехода в режим глубокого насыщения с помощью дополнительной нелинейной входной цепи с диодом. Обычный базовый резистор Rg здесь составлен из двух: Rci и Rgz-Если на вход данного элемента РТЛ от переключателя S1 поступает напряжение высокого уровня, через резистор Rg; течет входной ток 1. Номиналы Rd и Код нетрудно рассчитать так, чтобы пороговое напряжение открывания диода Uпор оказалось бы меньше, чем падение напряжения на резисторе Rgg, т. е. IgRga. Здесь символом Ig обозначен предельный, близкий к насыщающему базовый ток транзистора VT1. Если диод VD1 откроется, через него потечет избыточный входной ток который теперь минует базу транзистора и получит путь для стекания в землю через промежуток транзистора коллектор — эмиттер.