Комплект технологической документации по оптической контактной литографииРефераты >> Журналистика >> Комплект технологической документации по оптической контактной литографии
Введение
Оптическая литография объединяет в себе такие области науки, как оптика, механика и фотохимия. При любом типе печати ухудшается резкость края (рис. 1). Проецирование двумерного рисунка схемы ведет к уменьшению крутизны края, поэтому нужен специальный резист, в котором под воздействием синусоидально модулированной интенсивности пучка будет формироваться прямоугольная маска для последующего переноса изображения травлением. Если две щели размещены на некотором расстоянии друг от друга, то неэкспонируемый участок частично экспонируется по следующим причинам:
1) дифракция;
2) глубина фокуса объектива;
3) низкоконтрастный резист;
4) стоячие волны (отражение от подложки);
5) преломление света в резисте.

Таким образом, задача фотолитографии заключается в том, чтобы обеспечить совмещение и воспроизвести в резисте двумерный рисунок фотошаблона с точностью в пределах ±15% от номинального размера его элементов и с 5%-ным допуском на требуемый наклон краев. Послойное совмещение приборных структур должно осуществляться с точностью не хуже ±25% от размера минимального элемента. Используемые в фотолитографии источники экспонирующего излучения бывают как точечными (лазеры), так и протяженными (ртутные лампы). Спектр излучения этих источников лежит в трех основных спектральных диапазонах: Дальний УФ от 100 до 200-300 нм;
Средний УФ 300-360 нм; Ближний УФ от 360-450.
Современные литографические процессы в технологии ППП и ИС.
Плотность элементов в кристалле ИМС достаточно велика и к настоящему времени существенно превысила рубеж 100000. Это достигнуто за счёт уменьшения минимального геометрического размера, который уже составляет величину порядка 1 мкм. Последнее обстоятельство связано с усовершенствованием в первую очередь таких технологических процессов как литография, плазменное травление и локальное окисление.
Процессы легирования, а также наращивания слоев различных материалов призваны сформировать вертикальную физическую структуру ИМС. Необходимые форма, размеры, элементов и областей в каждом слое структуры обеспечиваются процессом фотолитографии
Разработчики ряда зарубежных фирм считают, что в технологии СБИС на современном уровне с успехом можно использовать оптическую литографию (фотолитографию). Её предельные возможности оцениваются в 2 мкм, хотя предполагают, что доступно достижение линий микронной ширины. Известно, что разрешающая способность литографического процесса не может быть меньше длины волны света, используемого для экспонирования. Для фотолитографии этот предел составляет 0, 5 мкм при использовании когерентного яркого источника света с длиной волны 200 нм при длительном экспонировании. Возможности оптической литографии определяются в большей степени точностью совмещения и разбросом рабочих параметров аппаратуры. Успешно работает аппаратура, дающая 2 мкм при фотолитографии с малым зазором на пластинах диаметром более 100 мм. Такую же разрешающую способность имеет рентгеновская литография с зазором. Электронно-лучевая литография даёт разрешение 0, 4 мкм, но из-за высокой стоимости и низкой производительности используется лишь для изготовления фотошаблонов и специальных ИС.
В результате полагают, что в течение ближайших лет оптическая литография останется основным технологическим методом формирования рисунков БИС. Использование когерентного света в дальнем ультрафиолете и фоторезистов, чувствительных к свету с длиной волны 0, 24 мкм, а также применение лазерных устройств совмещения позволит достичь разрешения в 1 мкм. В таблице 1 приведены основные параметры, используемых в технологии БИС литографических процессов, а на рис. 1 показана взаимосвязь минимального размера со стоимостью технологического процесса.
Традиционно классическим процессом является контактная фотолитография, при которой фотошаблон непосредственно соприкасается с полупроводниковой пластиной, на поверхность которой нанесён фоторезист. Основным недостатком контактной фотолитографии является ограниченное число циклов контактирования (как правило не более 70-80) и уменьшение выхода годных по циклам. Однако современный уровень контактной фотолитографии достаточно высок и в условиях серийного производства составляет 3 мкм. Установки с номинальными 3 мкм – проектными нормами успешно применяют для изготовления БИС с минимальным размером всего 2, 5 мкм.
Параллельно интенсивно реализовался переход от контактной фотолитографии и литографии с зазором к проекционной фотолитографии, где экспонирование осуществляется через промежуточный шаблон, отстоящий от пластины на несколько мм, причём иногда с уменьшением размеров при проецировании.
Таблица 1
Основные параметры литографических процессов
|
Способ литографического процесса |
Минимальная ширина линии, мкм |
Ошибка совмещения, мкм |
|
Контактная фотолитография λ=360-460 нм |
1, 25 – 1, 5 |
0, 25-1, 0 |
|
Проекционная фотолитография λ=360-460 нм |
0, 75-1, 0 |
0, 1-0, 2 |
|
Электронная литография λ=50-100 нм |
0, 25 |
0, 03 |
|
Рентгеновская литография λ=0, 1-10 нм |
0, 5 |
0, 03-0, 05 |
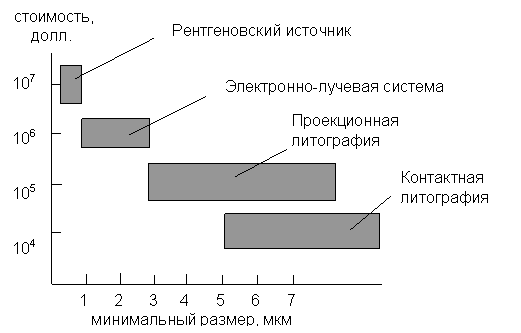
Рис. 1 Взаимосвязь минимального размера со стоимостью его реализации различными литографическими процессами.
Современные системы проекционной литографии в масштабе 1:1 рассчитаны на 1 мкм топологическую проектную норму и предусматривают, на пример, обработку пластин диаметром 125 мм при точности совмещения рисунков всех слоёв не хуже ±0, 25 мкм.
Фоторезисты.
Фоторезисты – это светочувствительные и стойкие к агрессивно воздействующим факторам вещества, представляющие собой сложные полимерно-мономерные системы, в которых под действием излучения протекают фотохимические процессы. Под действием света в таком синтетическом полимере происходит либо структурирование (сшивание), либо деструкция (разрушение) молекулярных цепей. В первом случае Фоторезисты называют негативными, а во втором – позитивными. Современные позитивные Фоторезисты (ФП) – это сложные эфиры нафтохинондиазидов сульфокислоты и фенолформальдегидных смол. Условно его структуру можно представить как R1-O-R2, где R1 и R2 –светочувствительная и полимерная составляющие части фоторезиста соответственно, а О - соединяющий их кислород.
Критерием применимости фоторезиста являются его чувствительность, разрешающая способность и кислотостойкость.
