Комплект технологической документации по оптической контактной литографииРефераты >> Журналистика >> Комплект технологической документации по оптической контактной литографии

Рис. 4 Схема установки для рентгеновской литографии.
Проявляют рентгенорезист в смеси, содержащей 40% метизобутилового кетона и 60% изопропилового спирта.
Основным преимуществом рентгеновской литографии является высокая разрешающая способность. Дифракционные эффекты, препятствующие использованию видимого и даже коротковолнового УФ - света, не являются помехой для рентгеновских лучей, длина волны которых менее 1 нм. Системы рентгеновской литографии работают почти также, как и системы оптической литографии. Однако существенным недостатком являются их малая производительность, высокая стоимость и невысокая чувствительность рентгенорезиста. Для компенсации последнего необходимо получение рентгеновских лучей с высокой энергией. Проблемой является также большая(1000 об/мин) скорость вращения мишени – массивного металлического диска, на кромку которого нанесён материал мишени. Высокие скорости вращения диска необходимы для охлаждения материала мишени, однако из-за возникающей вибрации в конструкции системы, снижается точность совмещения рисунка ИМС.
Электронно-лучевая литография.
Электронно-лучевым методом можно легко получать линии шириной 0, 25 мкм. Возможности электронно-лучевых систем очень высоки: точность совмещения 0, 03 мкм, минимальный размер – 1 мкм. В отличие от других методов литографии электронно-лучевой метод не требует масок или шаблонов, позволяет быстро перестраивать производство без существенных капитальных затрат, так как не надо изготавливать фотошаблоны, а изменения в топологию ИМС можно вносить путём изменения программы управления от ЭВМ. Электронно-лучевой метод содержит меньшее число технологических операций, что снижает трудоёмкость процесса в целом, однако, трудоёмкость некоторых операций высока. На пример, время, затрачиваемое на экспонирование одной пластины 100 мм диаметром, составляет порядка10-15 мин.
Электронно-лучевое экспонирование выполняется в вакуумных установках и основано на нетермическом взаимодействии ускоренных электронов с электронорезистом. В качестве последнего применяют различные полимерные материалы, в том числе и Фоторезисты. Предпочтение отдаётся специальным электронорезистам, нечувствительным к видимому и УФ - излучениям. Электронорезист также должен иметь низкое давление собственных паров и не должен образовывать химических соединений, загрязняющих вакуумную камеру установки.
Электронорезисты подразделяют на позитивные и негативные в зависимости от того разрывает поток падающих электронов химические связи в их структуре или, наоборот, укрепляет (структурирует) молекулы электронорезиста. В каждом конкретном полимере преобладает тот или другой эффект. Степень структурирования и деструкции позитивных элетронорезистов прямо пропорциональна дозе облучения, т.е. величине заряда электронов на единицу площади. Структурные изменения в электронорезисте произойдут полностью, если длина свободного пробега электронов будет больше толщины слоя электронорезиста.
Установки электронно-лучевой литографии обеспечивают ускоряющее напряжение порядка 104В, что соответствует длине волны 50-100 нм. Чем больше ускоряющее напряжение, тем меньше длина волны и меньше минимальный размер элемента. Технически считается возможным получение потока электронов с длиной волны менее 0, 1 нм, т.е. возможна разрешающая способность, близкая к 10-4 мкм.
Используют два метода электронно-лучевой литографии: сканирующую и проекционную литографию.
Сканирующая электронно-лучевая литография – это обработка сфокусированным единичным пучком поверхности пластины, покрытой электронорезистом. Для экспонирования в этом случае применяют растровые электронные микроскопы (РЭМ) или электронно-лучевые ускорители (ЭЛУ). РЭМ позволяет получать линии рисунка шириной 0, 1 мкм. При управлении лучом от ЭВМ применяют векторное сканирование. В этом случае электронный луч сканирует только запрограммированный участок, выключаясь в местах перехода от одного элемента к другому. Для увеличения площади экспонирования наряду с перемещением луча осуществляют управляемое от ЭВМ перемещение столика, на котором расположена пластина с электронорезистом. Совмещение топологических слоёв ИМС выполняется автоматически с помощью реперных меток, отражаясь от которых с отклонением, электронный луч даёт сигнал ЭВМ о несовмещении, в результате ЭВМ изменяет положение пучка. Точность совмещения составляет ±0, 5 мкм.
Проекционная электронно-лучевая литография – это электронная проекция всего изображения, в результате которой на электронорезист передаётся одновременно весь рисунок фотошаблона. В качестве последнего используют трёхслойный катод, который выполняет роль шаблона и одновременно является источником электронов. Рисунок шаблона в масштабе М 1:1 выполняют на слое диоксида титана, который непрозрачен для УФ - излучения. Поверх рисунка наносят плёнку палладия, обладающую высокими фотоэмиссионными свойствами. Фотокатод со стороны основы, выполненной из кварца, облучают УФ - излучением. Участки поверхности, покрытые плёнкой палладия, под действием УФ - излучения эмитируют электроны, которые ускоряясь в электрическом поле с помощью фокусирующей системы, проецируют изображение без искажения. Отклоняющая система установки позволяет смещать изображение и, тем самым, проводить совмещение с точностью ±0, 25 мкм.
Проекционный метод имеет хорошее разрешение, позволяющее получать линии шириной 1 мкм, большую до ±50 мкм глубину резкости. Производительность метода сравнима с фотолитографией.
К недостаткам метода можно отнести сложность изготовления фотокатодов и сложность подсоединения детекторов для совмещения.
Описание технологического процесса
Уважаемый преподаватель курсовая скачена из интернета и студентом даже не прочитана
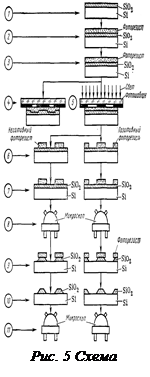 Процесс контактной фотолитографии состоит из ряда пунктов представленных на рисунке 5.
Процесс контактной фотолитографии состоит из ряда пунктов представленных на рисунке 5.
подготовка поверхности исходной подложки;
нанесение на подложку слоя фоторезиста;
первая сушка фоторезиста — пленкообразование;
совмещение рисунка фотошаблона с рисунком на исходной подложке (если процесс фотолитографии повторяется с изменением; фотошаблона);
экспонирование фоторезиста контактным способом;
проявление фоторезиста;
вторая сушка фоторезиста — полимеризация;
контроль рельефа рисунка в пленке фоторезиста;
травление подложки;
снятие пленки фоторезиста с поверхности подложки;
контроль рельефа рисунка в подложке.
1. Начинаем процесс с очистки поверхности пластин от загрязнений способных влиять на структуру фоторезиста:
молекулярные загрязнения – органические (масла, жиры, остатки фоторезиста, растворителей и др.), механические (пыль, абразивные частицы, ворсинки) и плёнки химических соединений (окислы, сульфиды, нитриды и др.);
ионные загрязнения – соли, основания и кислоты из остатков травильных растворов, химически связанные с поверхностью пластины;
