Комплект технологической документации по оптической контактной литографииРефераты >> Журналистика >> Комплект технологической документации по оптической контактной литографии
Сушильный аппарат рассмотренный на рис. 15, предназначен для предварительного прогрева, и сушки подложек. Максимальная температура разогрева подложек 150 0С точность удержания ее +/-10C на 1000C. Преимуществами данного аппарата являются: простота конструкции, компактные размеры, низкое (350 Вт.) энергопотребление.
Подложку устанавливаем на крышку 1 рис. 16, с отверстиями вакуумного зажима 2, крышка 1 на шарнирах 5, для загрузки откидывается на угол 1800. СВЧ генератор 7 на базе магнетрона передает излучение по волноводу 6 в рупорную антенну 3 с корректирующей диэлектрической линзой (она применяется для создания плоского фронта СВЧ волн). Закрываем крышку 1 и подложка оказывается над рупорной антенной 3 отделенной от нее защитным экраном 4
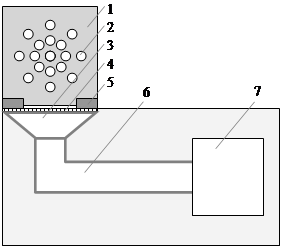
Рис. 16 Принципиальная схема сушильной установки Sawatec HP 150
Магнетрон рис. 17 состоит из анодного блока 1, который представляет собой, металлический толстостенный цилиндр с прорезанными в стенках полостями, выполняющих роль объёмных резонаторов 2. Резонаторы образуют кольцевую колебательную систему. Соосно анодному блоку закрепляется цилиндрический катод 3. Внутри катода закреплён подогреватель. Магнитное поле, параллельное оси прибора, создается внешними электромагнитом. Для вывода СВЧ энергии 5 используется, проволочная петля 6, закреплённая в отверстие из резонатора наружу цилиндра. Так как в магнетроне с одинаковыми резонаторами разность частот получается недостаточной, её увеличивают введением связок 4 в виде

Рис.17 Принципиальная схема магнетрона.
металлических колец, одно из которых соединяет все чётные, а другое все нечётные ламели 7 анодного блока.
Микроскоп Nikon Eclipse L200A рис. 18 это идеальный инструмент для полуавтоматической инспекции полупроводниковых пластин в светлом и темном поле, диаметром до 200мм и интегральных микросхем в отраженном свете на наличие дефектов.
Для темнопольнои микроскопии пользуются обычными объективами и специальными темнопольными конденсорами. Основная особенность темнопольных конденсоров заключается в том, что центральная часть у них затемнена и прямые лучи от осветителя в объектив микроскопа не попадают. Объект освещается косыми боковыми лучами и в объектив микроскопа попадают только лучи, рассеянные частицами. Чтобы в объектив не попадали прямые лучи от осветителя, апертура объектива должна быть меньше, чем апертура конденсора. Для уменьшения апертуры в обычный объектив помещают диафрагму или пользуются специальными объективами, снабженными ирисовой диафрагмой.
При темнопольной микроскопии частицы выглядят ярко светящимися на черном фоне. При этом способе микроскопии могут быть обнаружены мельчайшие частицы, размеры которых лежат за пределами разрешающей способности микроскопа. Однако темнопольная микроскопия позволяет увидеть только контуры объекта, но не дает возможности изучить внутреннюю структуру. Для темнопольной микроскопии применяют более мощные осветители и максимальный накал лампы.
Часто повторяющиеся операции такие как: смена методов контрастирования и объективов, управление апертурой, фокусировка и регулировка интенсивности освещения выполнены на передней панели рис. 19, моторизированы и могут управляться с панели управления рис. 20. Моторизация и внешняя панель управления, обеспечивает быстрое и простое управление микроскопом не отрывая глаз от объекта исследования. При этом фактически отсутствует необходимость каких либо ручных манипуляций над образцом, что предотвращает его загрязнение по вине оператора. Элементы микроскопа покрытые составом, обеспечивающим электростатическое разряжение, для предотвращения электростатических разрядов, и адгезии посторонних частиц к микроскопу, что минимизируют вероятность загрязнения объекта исследования, увеличивая производительность.
Оптимальные условия наблюдения могут быть сохранены отдельно для каждого объектива и восстановлены лишь простой сменой увеличения.
Такая возможность обеспечивает полную воспроизводимость результатов исследования, а так же существенно ускоряет работу с микроскопом. Процесс инспекции может меняться в зависимости от типа подложки и предпочтений пользователя. Поэтому возможность программирования исключает рутинный процесс подстройки. Чтобы начать работу, нужно лишь выбрать сохраненный файл с именем оператора, и применить предустановки в зависимости от метода контрастирования, увеличения объектива, объекта исследования, фокусировки, позиции столика, апертуры и интенсивности света.
Оценка технологического процесса
Основными контролируемыми параметрами являются геометрические размеры, топология и наличие дефектов покрытия. Контроль проводится при помощи полу автоматизированного микроскопа Nikon Eclipse L200А (описанного выше) в светлом и темном поле.
1. Процесс отмывки, описанный выше в п. 1 описания технологического процесса, оканчивается контролем качества отмывки. Посторонние частицы и другие точечные загрязнения на подложке дают преломление света, в темном поле микроскопа и выглядят ˝звездами˝ на темном фоне. Количество этих частиц практически пропорционально количеству забракованных ИМС, оценку их количества проводим подсчитывая число потенциального брака, визуально. При большом количестве точек, больше расчетного относительно ранее проведенного процесса, проводится более тщательная очистка.
2. После проявления и полимеризации фоторезиста п. 8 описания технологического процесса, контроль рельефа в пленке фоторезиста проводим визуально под микроскопом. Проверяя всю рабочую поверхность подложки с имеющимися на ней элементами рисунка из пленки фоторезиста. Контролируются следующие основные критерии качества пленки: чистота рабочего поля пленки фоторезиста, наличие проколов и их количество, геометрические размеры элементов рельефа, неполное удаление фоторезиста в окнах, искажение формы элементов рисунка, наличие ореола и клина в рельефе рисунка. При обнаружении того или иного дефекта в пленке фоторезиста проводят анализ возможных причин его появления. После этого составляют план мероприятий по доработке отдельных технологических операций.
3. После удаления фотомаски п. 11 описания технологического процесса, контроль рельефа в подложки проводим визуально под микроскопом. Контролируя рабочую поверхность на соответствие ее топологии и геометрии элементов плану. Контролируются следующие основные критерии качества: наличие каверн, разрывов и их количество, геометрические размеры элементов рельефа; неполное удаление фотомаски, искажение формы элементов рисунка, наличие сужений, утолщений и изменений глубины рисунка. При обнаружении того или иного дефекта в пленке фоторезиста проводят анализ возможных причин его появления. После этого составляют план мероприятий по доработке отдельных технологических операций.
|
1 |
I | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
МГОУ |
605124 |
605124 ВТД | ||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Пластина |
0 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
С |
НПП |
Обозначение ДСЕ |
Наименование ДСЕ |
кп | ||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Ф |
НПП |
Обозначение комплекта ТД |
Наименование комплекта ТД |
листов | ||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Г |
Обозначение ТД |
Услов. обозн. |
Лист |
Листов |
Примечание | |||||||||||||||||||||||||||||||||||||||||||||||||||
|
Ф 1 |
605124 Пластина 9 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Ф 2 |
605124 ТЛ Титульный лист 1 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Ф 3 |
605124 ВО Ведомость оборудования 1 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
4 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
5 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
6 |
Сборочные единицы | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
7 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
С 8 |
605124 Пластина | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Г 9 |
605124 МК 4 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Г 10 |
605124 ОК 1 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Г 11 |
605124 ОКУ 3 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
12 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
13 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
14 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
15 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
16 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
17 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
18 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
19 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
20 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
21 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
22 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
23 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
24 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
25 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
26 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
27 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
28 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
29 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
30 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Разраб. | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Н. контр. | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
ВТД /ВДП |
Ведомость технологической документации | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
2 |
1 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
МГОУ |
605124 |
605124 ВО | ||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
0 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
С |
НПП |
Обозначение ДСЕ |
Наименование ДСЕ |
кл | ||||||||||||||||||||||||||||||||||||||||||||||||||||
|
В |
Цех |
уч. |
РМ |
Опер. |
Код, наименование операции | |||||||||||||||||||||||||||||||||||||||||||||||||||
|
Т |
опер. |
Обозначение ТО |
Кол |
Наименование ТО | ||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Д |
НПП |
Код, наименование оборудования | ||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
С 1 |
605124 Пластина | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
2 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Т 3 |
ADT 976 Установка отмывки OSTEC | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Д 4 |
EVG 101 Установка нанесения, проявления и снятия фоторезиста OSTEC | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Д 5 |
HP 150 Установка сушильная Sawatec | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Д 6 |
EVG 620 Установка совмещения и экспонирования OSTEC | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Т 7 |
БАВнп-01 1, 2(01) БОКС укрытие "Ламинар-С" | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Т 8 |
ТУ 64-1-37-78 Пинцет ПС 160 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Т 9 |
ТУ 3-3.1210-75М Микроскоп инспекционный Nikon Eclipse L200A | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Т 10 |
ВТМ 4.189. 017 Тара для хранения пластин | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
11 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
12 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
13 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
14 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
15 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
16 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
17 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
18 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
19 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
20 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
21 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
22 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
23 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
24 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
25 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
26 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
27 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
28 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
29 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
30 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Разраб. | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Н. контр. | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
ВО/ВОБ |
Ведомость оборудования | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
3 |
1 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
МГОУ |
605124 |
605124 МК | ||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
В |
Цех |
УЧ. |
РМ |
Опер. |
Код, наименование операции | |||||||||||||||||||||||||||||||||||||||||||||||||||
|
Г |
Обозначение документа | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Д |
Код, наименование оборудования | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Е |
см |
проф |
Р |
УТ |
КР |
КОИД |
ЕН |
ОП |
К шт |
Тпз |
Т шт | |||||||||||||||||||||||||||||||||||||||||||||
|
Л/М |
Наименование детали, сб. единицы или материала | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Н/М |
Обозначение, код |
ОПП |
ЕВ |
ЕН |
КИ |
Н. расх. | ||||||||||||||||||||||||||||||||||||||||||||||||||
|
В 1 |
005 Очистка подложки | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
2 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Г 3 |
605124 ОКУ | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
4 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Т 5 |
БАВнп-01 1, 2(01) БОКС укрытие "Ламинар-С" | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Т 6 |
ТУ 64 – 1 – 37 – 78 Пинцет ПС 160 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Т 7 |
ВТМ 4. 189. 017 Тара для хранения пластин | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
М 8 |
ОСТ 11.029.003 - 80 Вода деионизированная марки А | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Н 9 |
Склад Л 8 12 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
М 10 |
ГОСТ 9293-74 Азот газообразный | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Н 11 |
Склад Л 8 6 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Д 12 |
ADT 976 Установку отмывки OSTEC | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
13 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
В 14 |
010 Контроль качества отмывки | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
15 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Г 16 |
605124 ОК | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
17 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Т 18 |
БАВнп-01 1, 2(01) БОКС укрытие "Ламинар-С" | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Т 19 |
ТУ 64 – 1 – 37 – 78 Пинцет ПС 160 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Т 20 |
ВТМ 4. 189. 017 Тара для хранения пластин | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Д 21 |
ТУ 3-3.1210-75М Микроскоп инспекционный Nikon Eclipse L200A | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
22 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
В 23 |
015 Нанесение фоторезиста | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
24 | ||||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Г 25 |
605124 ОКУ | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
26 |
Уважаемый преподаватель курсовая скачена из интернета и студентом даже не прочитана | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Т 27 |
БАВнп-01 1, 2(01) БОКС укрытие "Ламинар-С" | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Т 28 |
ТУ 64 – 1 – 37 – 78 Пинцет ПС 160 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
|
Т 30 |
ВТМ 4. 189. 017 Тара для хранения пластин | |||||||||||||||||||||||||||||||||||||||||||||||||||||||
